表面反応の直接計測技術
表面反応は、吸着反応、表面拡散、会合反応、脱離反応の素過程から成りますが、それらの直接的な評価は容易ではありません。特に、反応性の高いラジカルの表面反応の定量化は困難を極めます。本テーマでは、超高真空環境と非平衡プラズマを組み合わせた分子線散乱装置や昇温脱離装置を新たに開発し、ラジカルを含む表面反応現象の理解とその詳細反応機構のモデリングに役立てることを目的としています。
・プラズマ分子線散乱法によるラジカルの吸着反応計測
分子線散乱実験では、オリフィスから放出された真空中を直進する分子流(分子線)を試料表面に照射し、散乱した分子の飛行時間分布を質量分析器により検知します。これにより、衝突分子の吸着確率などをはじめとした表面との相互作用を直接的に評価可能ですが、本手法は主に化学的に安定な原子・分子に適用されてきました。そこで、本研究では、プラズマを利用することで、ラジカルの散乱測定を可能としました。図1および図2は、プラズマ分子線散乱計測装置の模式図です。主室は、測定時のノイズ低減のため、10-9 Torr程度の超高真空状態に保っています。ラジカルの分子線は、非平衡プラズマ源を備えた差動排気ラインで形成されます。まずは、燃焼反応において極めて重要なHラジカルの吸着確率の定量化を試みました。図3は、入射線の飛行時間分布ですが,水素分子のプラズマ分解により、Hラジカル線を形成できることが分かります。図4は、Hラジカル線を用いて、燃焼器の材質としてよく用いられるステンレスの表面におけるHラジカルの吸着確率を初めて定量化した結果です。現在、酸素ラジカルや窒素ラジカルなど他のラジカルの吸着計測も進めています。
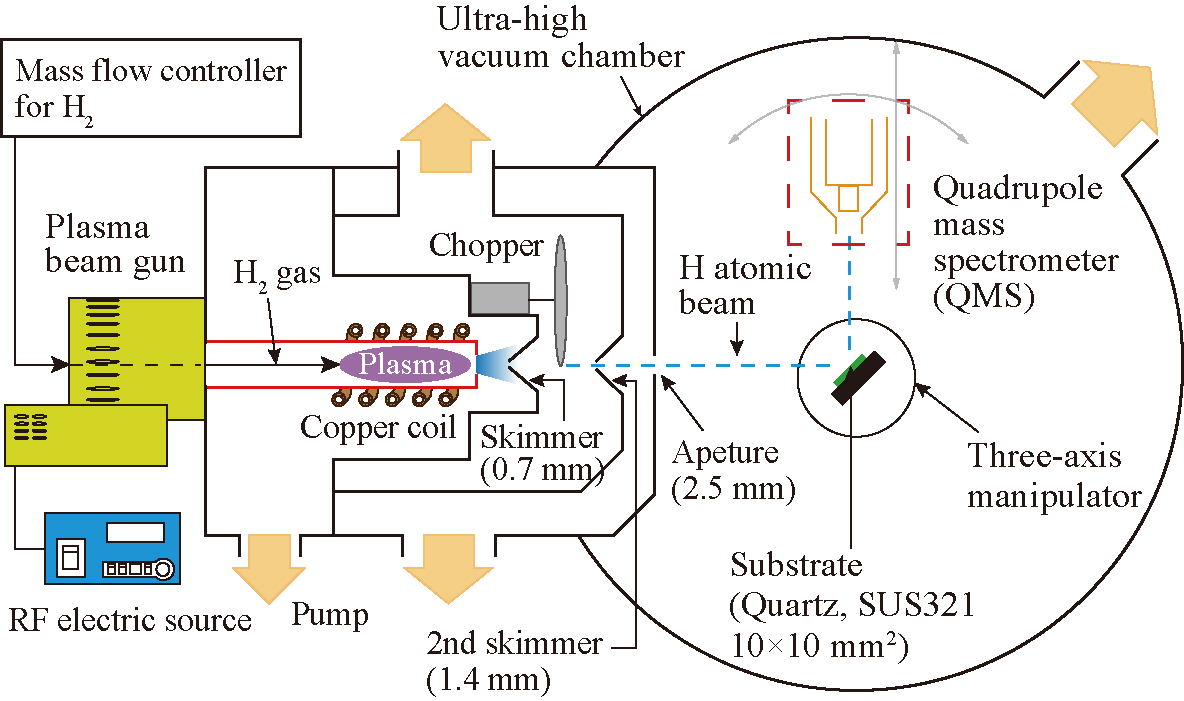
図1 非平衡プラズマ源を備えた分子線散乱装置の模式図

図2 ラジカル線・試料表面・質量分析器(QMS)の位置関係
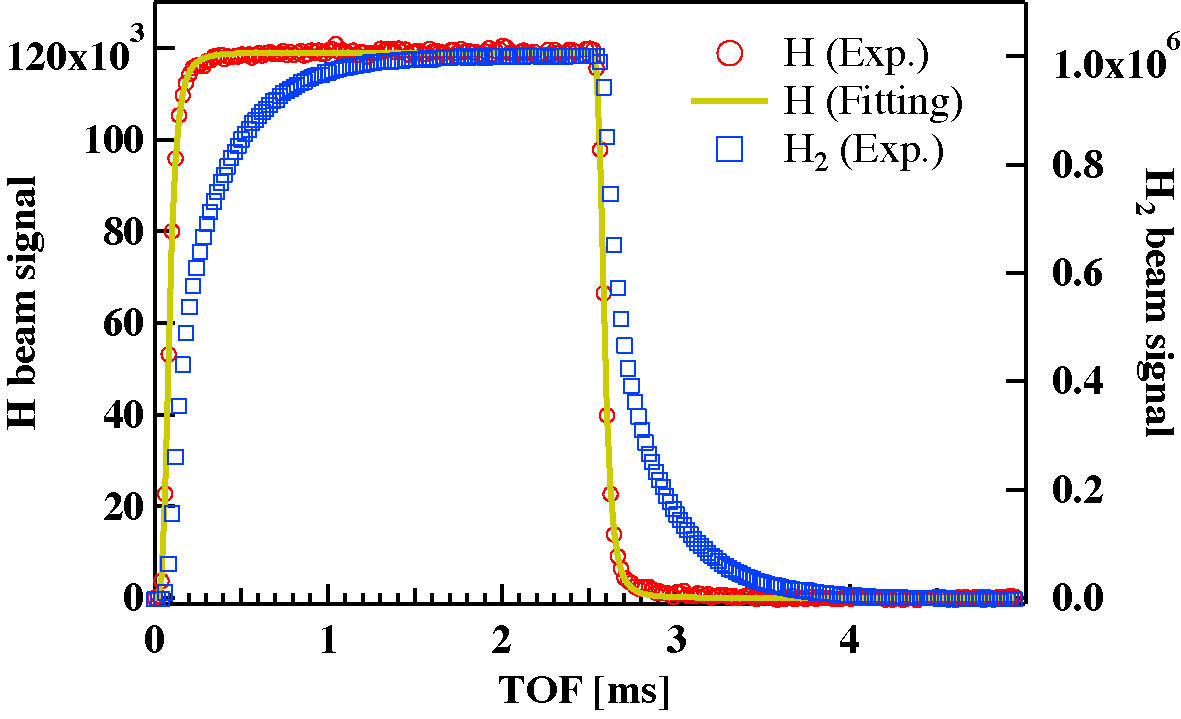
図3 Hラジカル入射線の飛行時間(Time-of-Flight: TOF)分布

図4 ステンレス表面におけるHラジカルの吸着係数